
Mikroelektronika
Mikroelektronika
TECHNOLOGIA
TECHNOLOGIA
GRUBOWARSTWOWA
GRUBOWARSTWOWA
WYKŁAD 3
WYKŁAD 3

TECHNOLOGIA GRUBOWARSTWOWA
TECHNOLOGIA GRUBOWARSTWOWA
Plan wykładu:
Plan wykładu:
1. Informacje ogólne
1. Informacje ogólne
2.
2.
Etapy wytwarzania
Etapy wytwarzania
3. Układy wysokotemperaturowe
3. Układy wysokotemperaturowe
4. Układy niskotemperaturowe
4. Układy niskotemperaturowe
(polimerowe)
(polimerowe)
5. Układy wielowarstwowe typu MCM
5. Układy wielowarstwowe typu MCM
(LTCC)
(LTCC)

Etapy
wytwarzania
PODŁOŻA
OBUDOWA
TEST
CIĘCIE
MONTAŻ
KOREKCJA
WYPALANIE
SUSZENIE
SITODRUK
SITA
PROJEKT
PASTY
PROJEKT

Projekt
Projektowanie rezystorów
Podstawowe parametry techniczne rezystorów grubowarstwowych:
R
1/ ÷ 100 M/
TWR
± 50 ppm/°C ÷ ± 300 ppm/°C
d - grubość warstwy
15 μm
rozrzuty wartości R
± 20%
P
r
(podłoże alundowe 96% Al
2
O
3
)
8 W/cm
2
P
p
(powierzchnia całego podłoża)
0,25 W/cm
2
S - wskaźnik szumów
-35 ÷ +35 dB

Etapy projektowania rezystora
1) Wybór rezystorów precyzyjnych wymagających
korekcji
R
p
= 0,8
2) Wybór pasty o odpowiedniej rezystancji
powierzchniowej
n = R
p
/R
n - ilość kwadratów (n = l/w) 1/3 < n <10,
l - długość rezystora,
w - szerokość rezystora
3) Wykonanie serii układów testowych
wyznaczenia
zależności R = f (l,w) ( l,w < 0,5 mm)

Projekt R cd
P
p
R
d
P
R
zn
4) Wyznaczenie minimalnej długości
l
i szerokości
w
a) n < 1
l
=
Dla l < 0,5 mm przyjmujemy wartość l = 0,5
mm w = l/n
b) n > 1
w
=
P
R
d
P
p
R
zn
Dla w < 0,5 mm przyjmujemy wartość w = 0,5 mm l =
w
.
n
5) Sprawdzenie sumy mocy rezystorów

R = f (l,w)

mieszanie past R
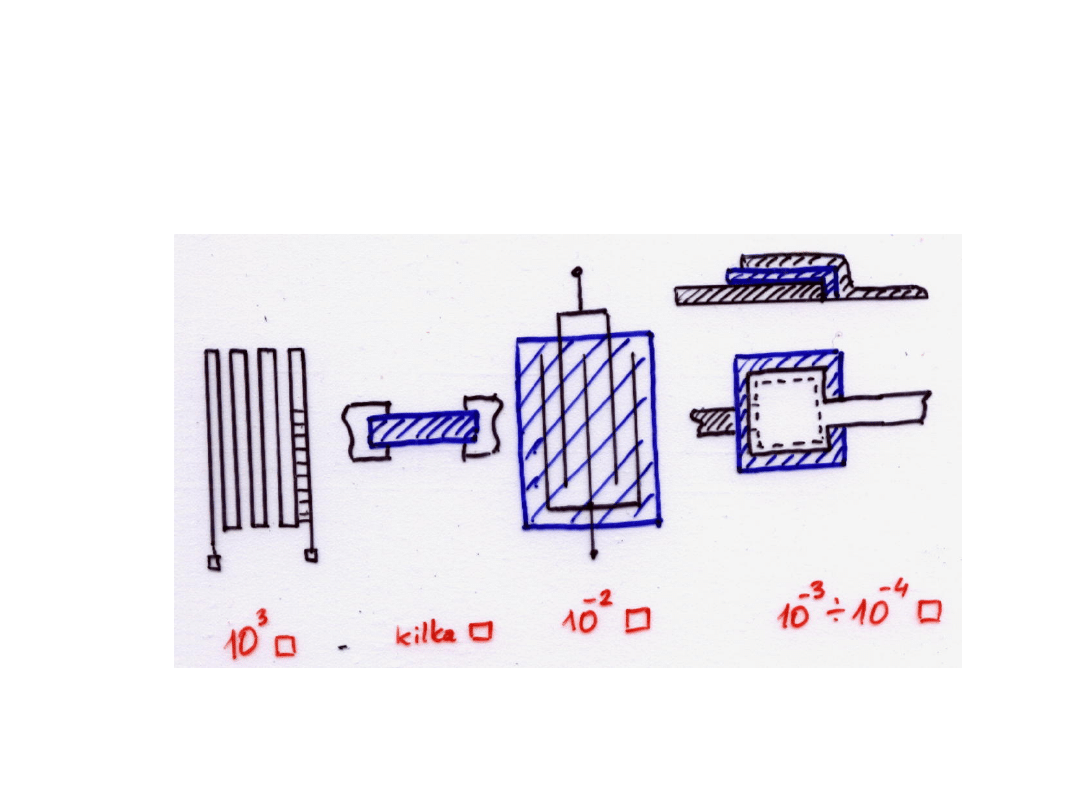
□
= f (kształt)
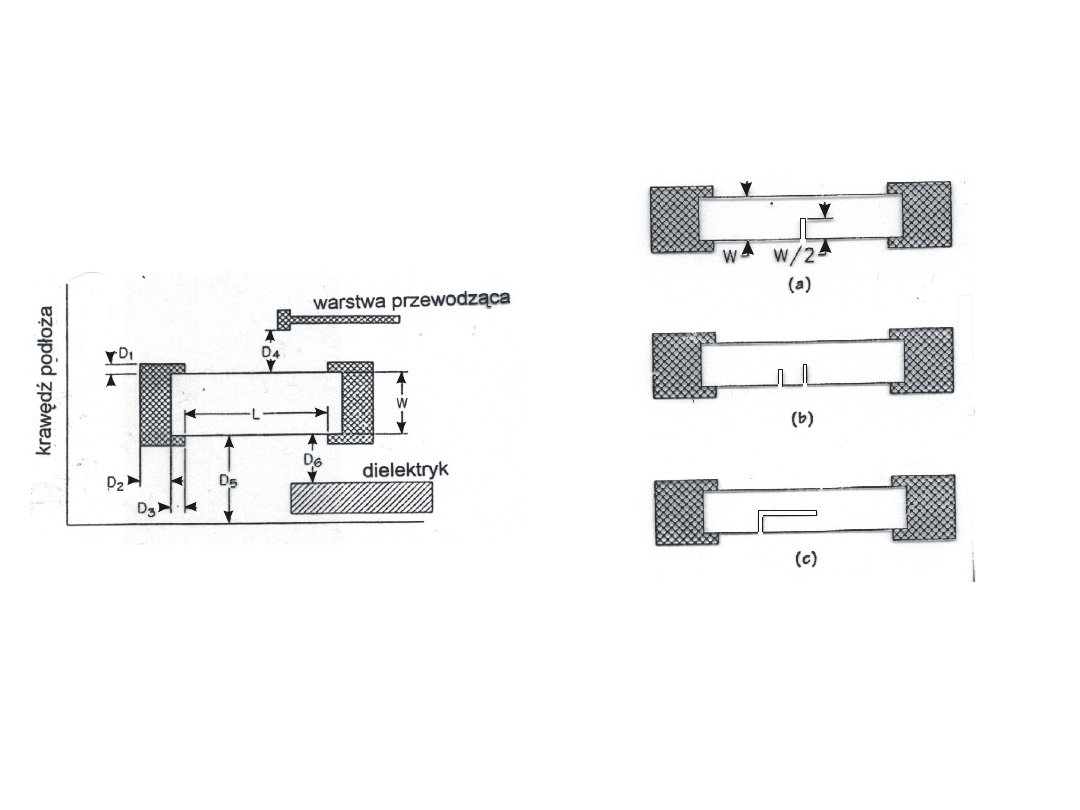
Projekt
Typowe wymiary rezystorów Nacięcia stosowane
przy korekcji
L = 1 (0,5) mm
laserowej
D
1
, D
2
= 0,25 (0,125) mm
D
3
= 0,25 (0,2) mm

Projekt
Typowe wymiary rezystorów grubowarstwowych
Oznaczenie
Długość
[m]
Uwagi
L
1000
(500)
0,5<L/W<5 (0,3<L/W<10)
W
szerokość zależy od tolerancji i
mocy
D
1
250 (125)
D
2
250 (125)
D
3
250 (200) zakładka
D
4
500 (375) odległość od warstwy
przewodzącej
D
5
750 (500) odległość od krawędzi podłoża
D
6
500 (500) odległość od warstwy
dielektrycznej
(i) – w nawiasach podano wartości minimalne

Projekt
- wymiary ścieżek przewodzących
Oznacze
nie
Wymiar
[m]
Uwagi
W
(125)
zależy od natężenia prądu lub rezystancji
W
1
250 (125)
W
2
500 (375)
metalizacja łącząca elementy po obu stronach
podłoża
D
1
250 (200)
długość ścieżki < 375 m
D
2
375 (250)
długość ścieżki 375 m
D
3
375 (250)
D
4
250 (250)
(i) – w nawiasach podano wartości minimalne

Projekt

Projekt

Projekt
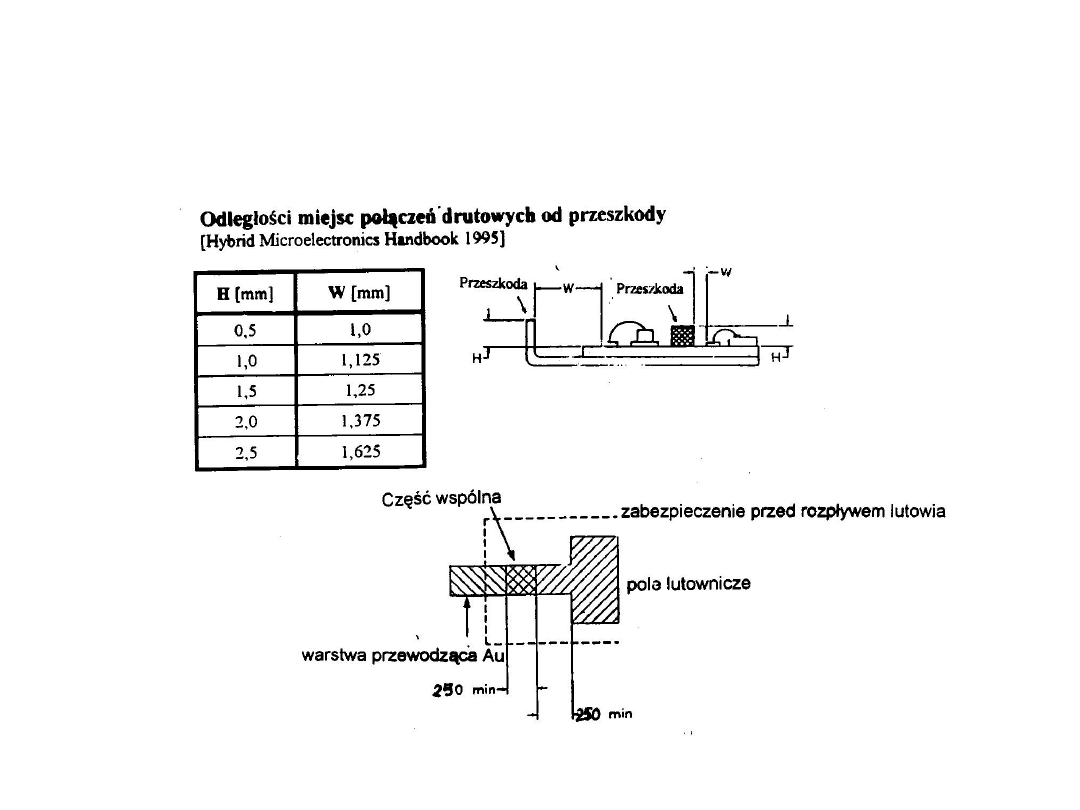
Projekt

Etapy
wytwarzania
PODŁOŻA
OBUDOWA
TEST
CIĘCIE
MONTAŻ
KOREKCJA
WYPALANIE
SUSZENIE
SITODRUK
SITA
PROJEKT
PASTY
SITA

SITA
b
a
b
a
x 100
% open =
(a-b)
2
a
2
sito 200:
a= 1/200''= 0.005''
b= 0.0021'' lub 0.0016''
b= 0.0021'' % open=
b= 0.0016'' % open=
x 100
(0.005 - 0.0021)
2
(0.005)
2
= 33.64%
46.25%
sito 250:
b= 0.0014" % open=
42.25%
b= 0.0011" % open=
sito 325:
41.28%
mesh
b [μm]
% open
grubość
druku
200
53
33.6
25
200
41
46.2
26
250
36
42.3
21
325
28
41.3
16
Tabela 5. Zależności grubości nadrukowanej warstwy (po wysuszeniu) od gęstości sita (mesh)
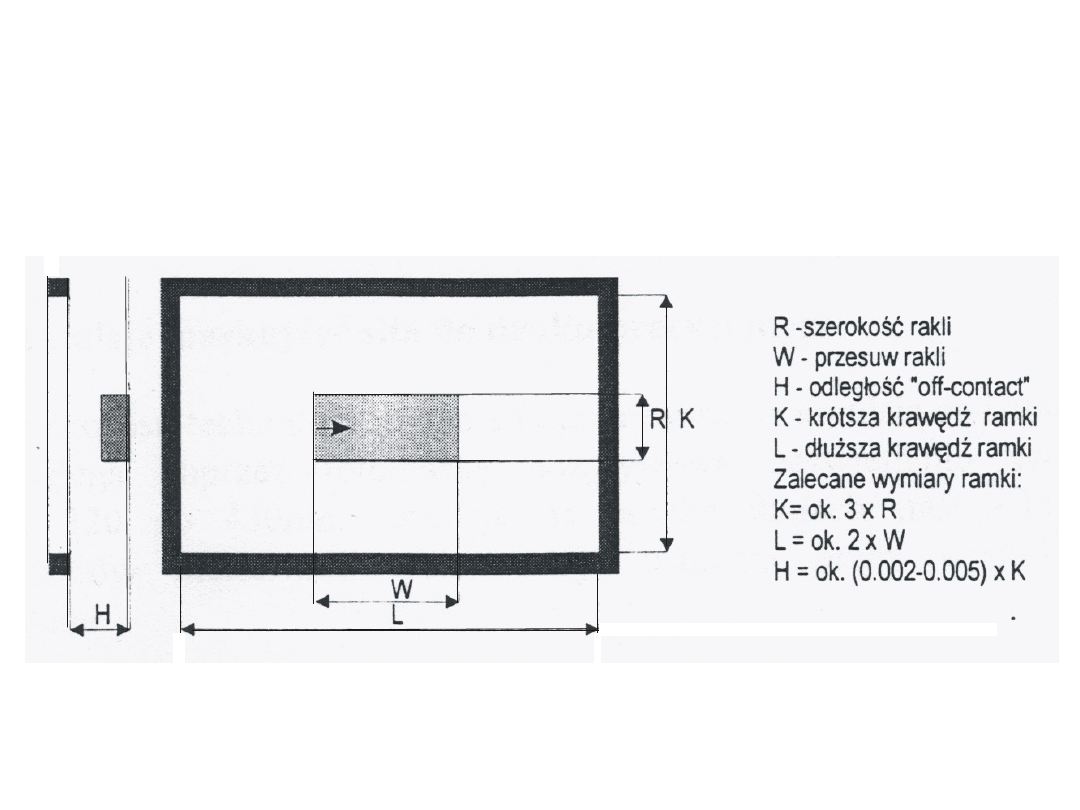
Sito
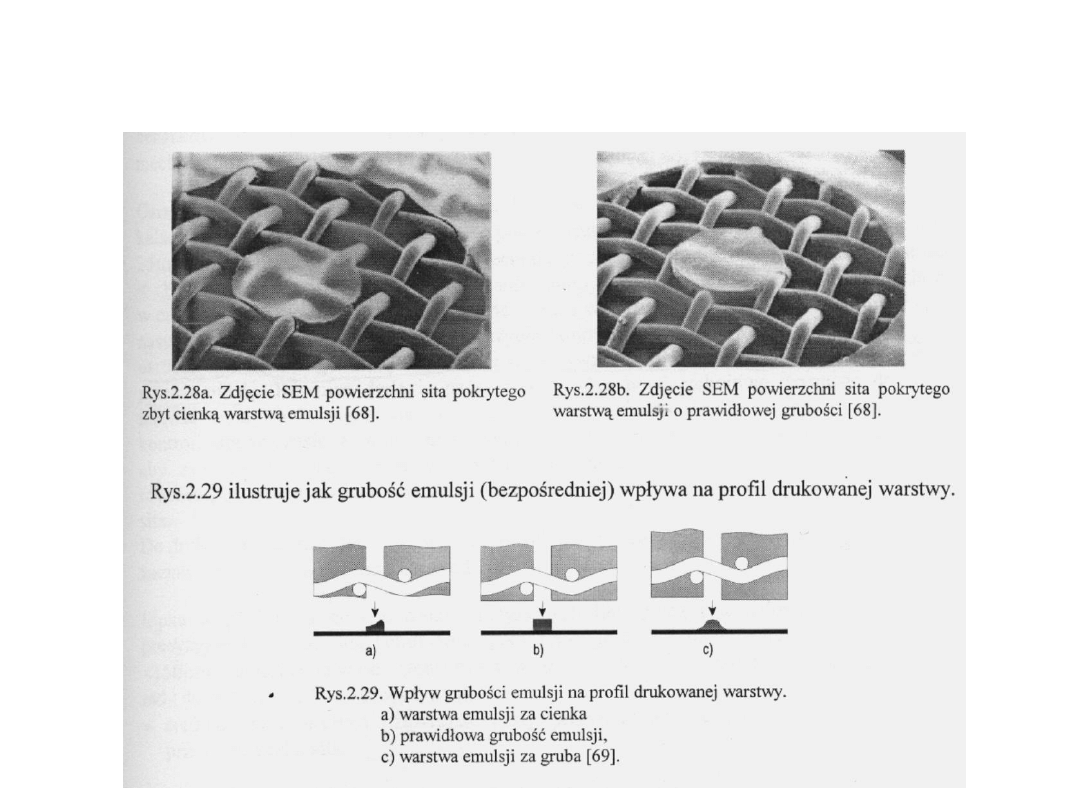
Sito

Etapy
wytwarzania
PODŁOŻA
OBUDOWA
TEST
CIĘCIE
MONTAŻ
KOREKCJA
WYPALANIE
SUSZENIE
SITODRUK
SITA
PROJEKT
PASTY
SITODRUK

Sitodruk
r a k la
p a s ta
s ito
r a m a
e m u ls ja
p o d ło ż e
Proces sitodruku

sitodrukarka DEK

właściwości reologiczne
z
V
V
V
V 1
2
3
( 1 )
( 2 )
x
a )
n
R
R
b )
R
R
c )
ciecz newtonowska
ciecz nienewtonowska
=
.
R
= F /
S
R
=
dv / dz
- naprężenie styczne
R
- szybkość ścinania
- lepkość
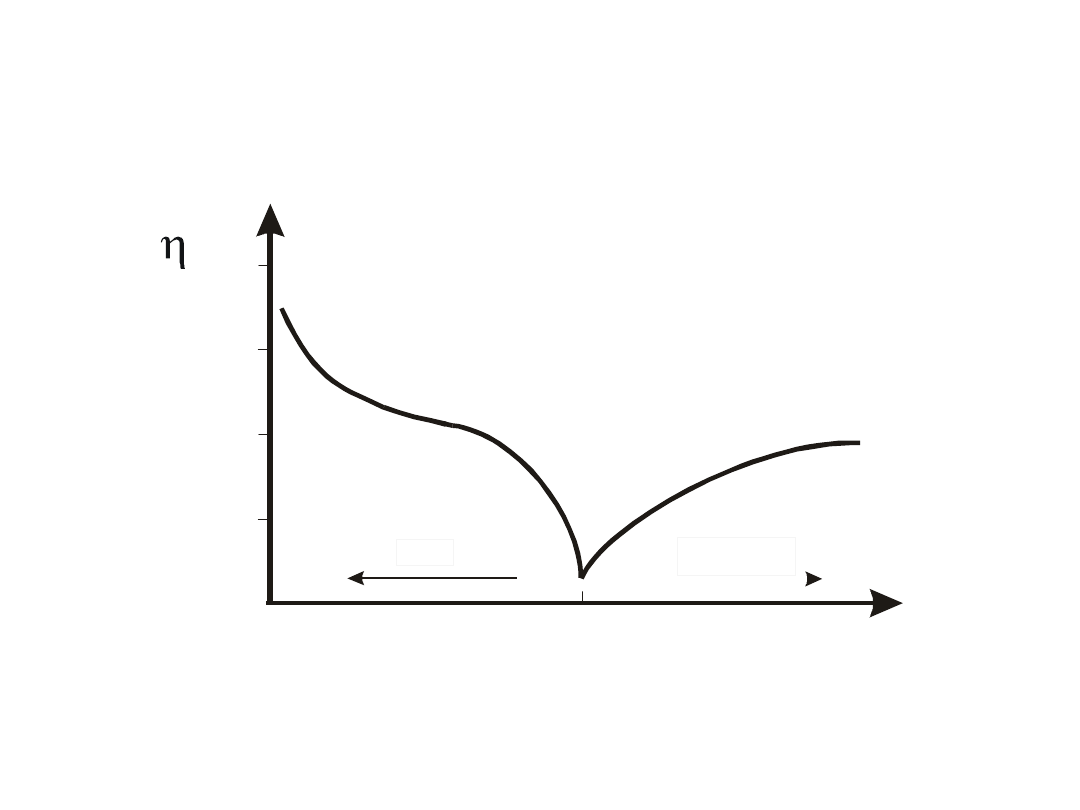
lepkość - sitodruk
p o d ł o ż e
s i t o
1 0
2
1 0
4
[ P ]
t
p a s t a n a s i c i e
p a s t a n a p o d ł o ż u
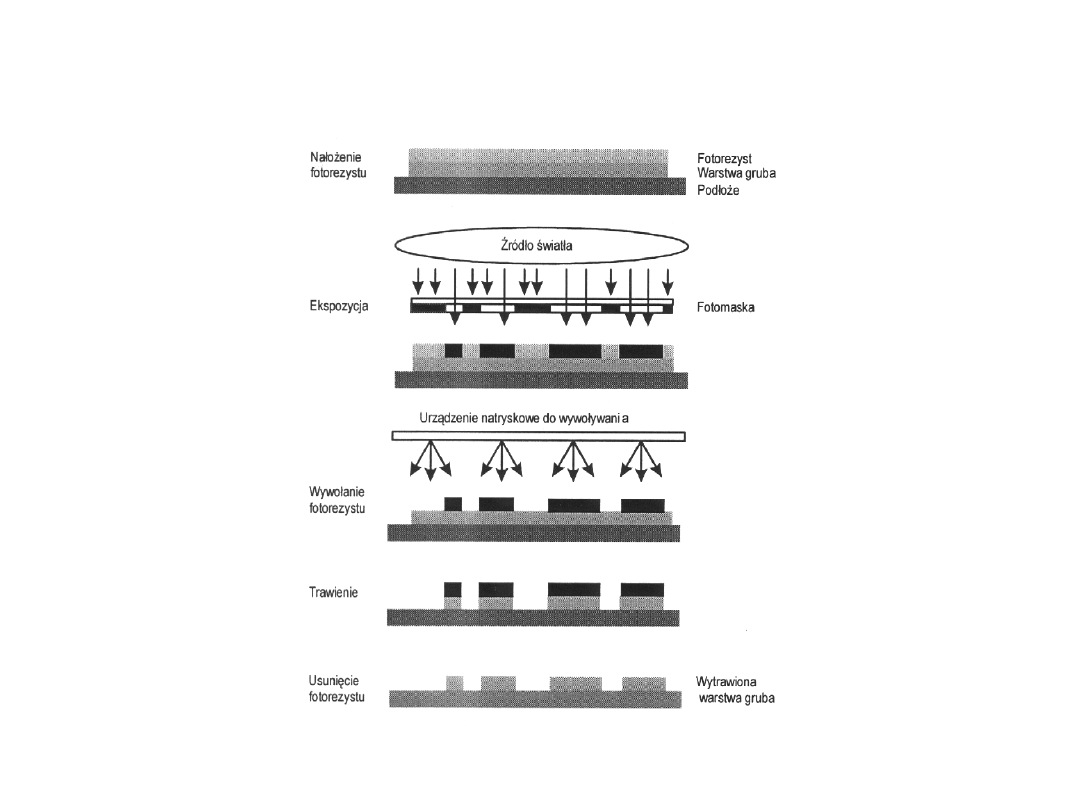
trawienie wypalonej warstwy
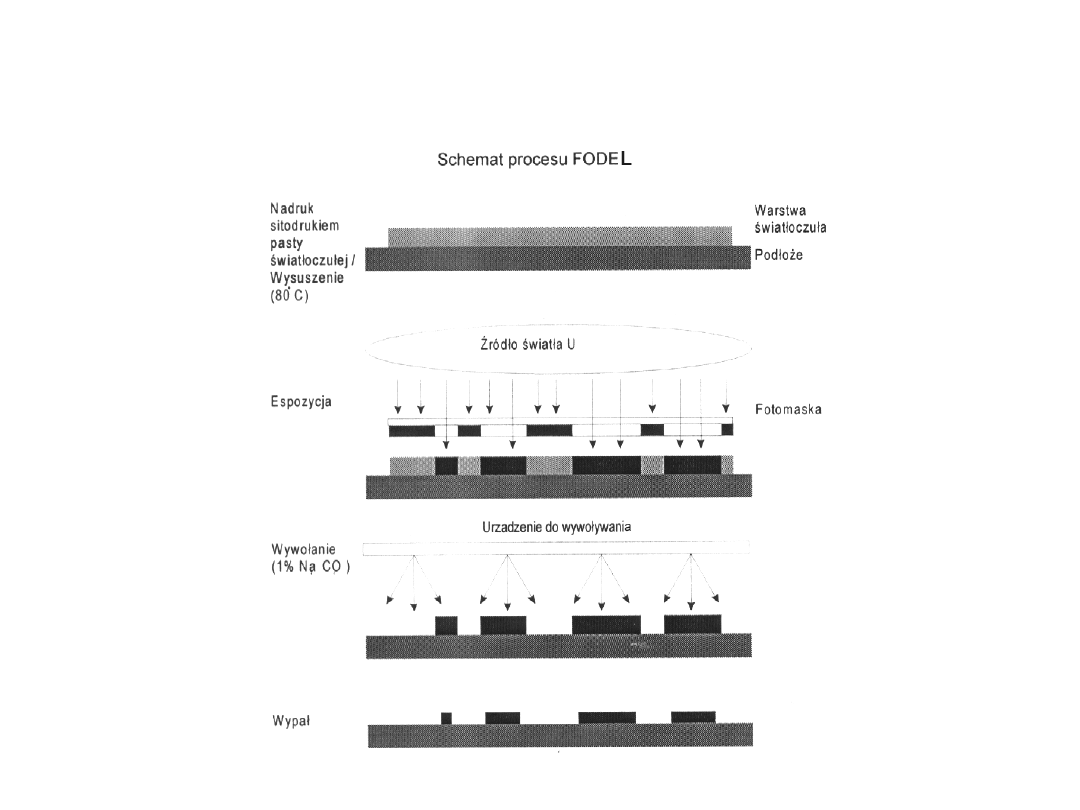
trawienie wysuszonej warstwy
światłoczułej (FODEL)

gravure - offset
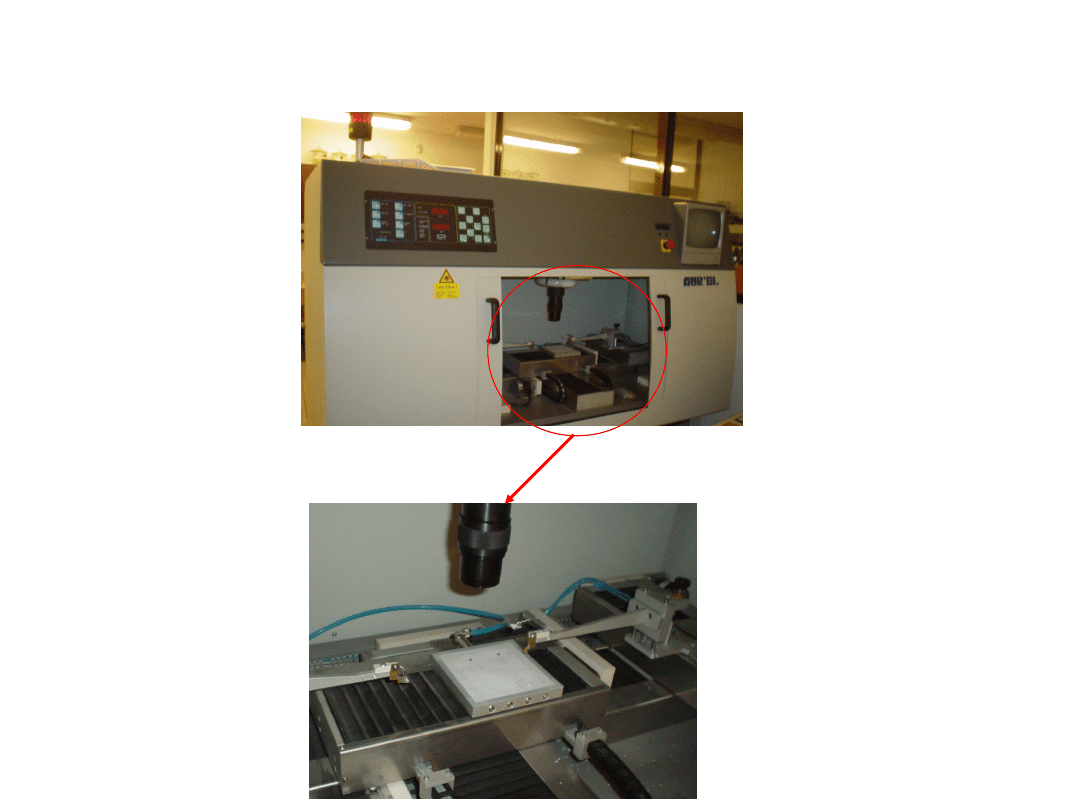
zastosowanie lasera
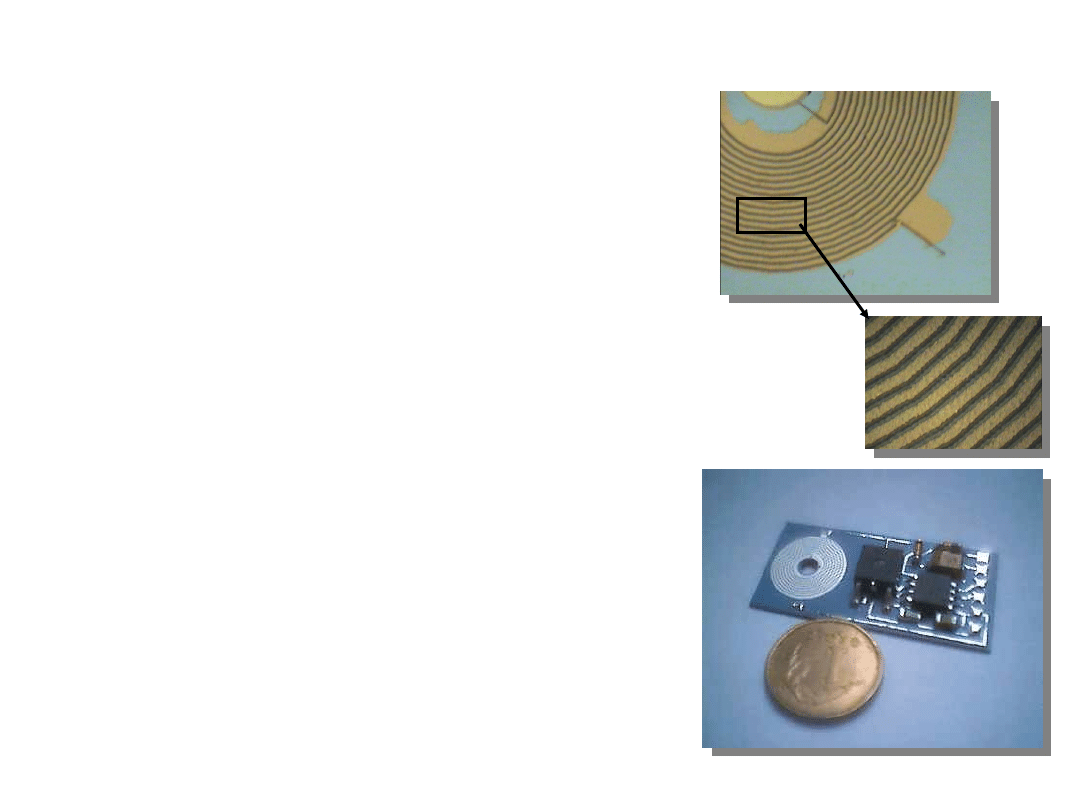
odległość – 80 m
minimalna
szerokość –
100 m
Wykorzystanie systemu
laserowego
przetwornik DC-DC
przetwornik DC-DC
- formowanie ścieżek
- formowanie ścieżek

Etapy
wytwarzania
PODŁOŻA
OBUDOWA
TEST
CIĘCIE
MONTAŻ
KOREKCJA
WYPALANIE
SUSZENIE
SITODRUK
SITA
PROJEKT
PASTY
SUSZENIE

Etapy
wytwarzania
PODŁOŻA
OBUDOWA
TEST
CIĘCIE
MONTAŻ
KOREKCJA
WYPALANIE
SUSZENIE
SITODRUK
SITA
PROJEKT
PASTY
WYPALANIE
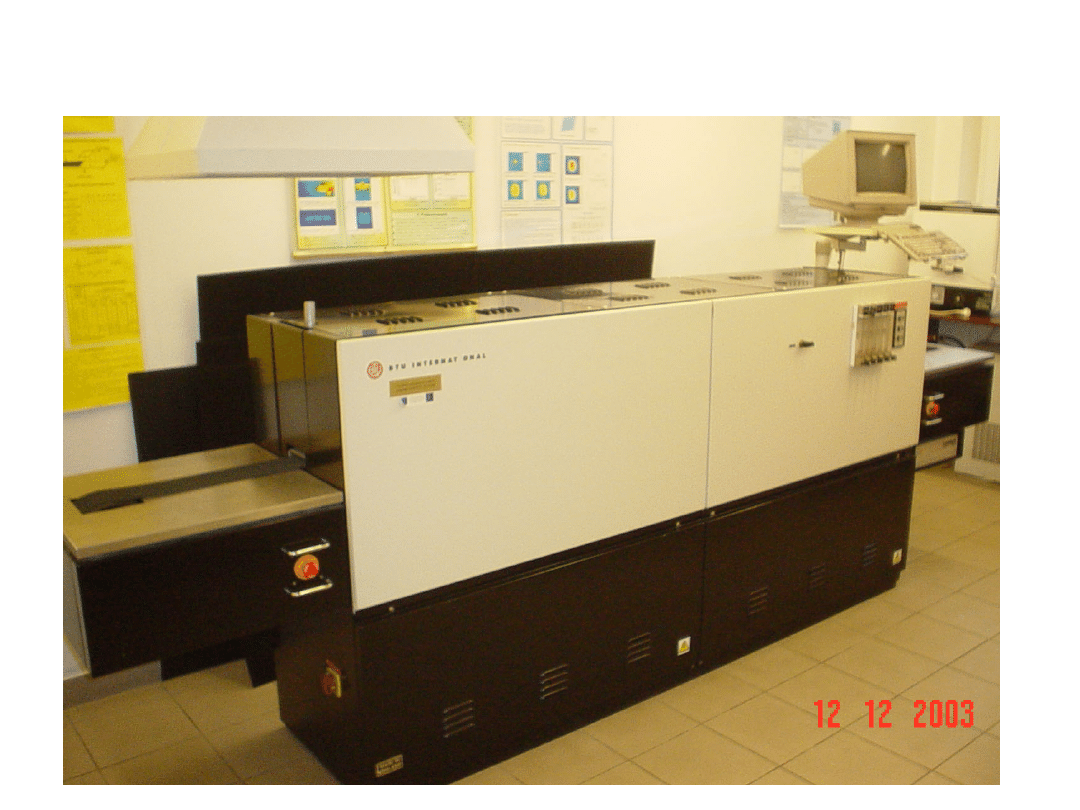
piec BTU
Document Outline
- Slide 1
- Slide 2
- Slide 3
- Slide 4
- Slide 5
- Slide 6
- Slide 7
- Slide 8
- Slide 9
- Slide 10
- Slide 11
- Slide 12
- Slide 13
- Slide 14
- Slide 15
- Slide 16
- Slide 17
- Slide 18
- Slide 19
- Slide 20
- Slide 21
- Slide 22
- Slide 23
- Slide 24
- Slide 25
- Slide 26
- Slide 27
- Slide 28
- Slide 29
- Slide 30
- Slide 31
- Slide 32
- Slide 33
Wyszukiwarka
Podobne podstrony:
Wykład 2 Mikroel IIIr 28 10 04
Wykład 1 Mikroel IIIr 21 10 04
Wykład 4 Mikroel IIIr 9 12 04
Wykład 5 Mikroel IIIr 6 01 05
6 Miedzynarodowy transfer wyklad 11 04 2012 id 43355
Wykład 11 (04.12.07), toxycologia
Geodezja wyklad 6 instrumenty geodezyjne (11 04 2011)(1)
2011.11.04 - Czynnosc bioelektryczna mozgu - Kopia, Fizjologia człowieka, wykłady
wykład z 11.04., I rok, Podstawy zarządzania
2010 11 04 WIL Wyklad 04id 2717 Nieznany
wyklad 7 11.04.2008, Administracja UŁ, Administracja I rok, Wstęp do prawoznawstwa
elementy ekonomii - wykład 5 (25.11.2007 r.), WSB, elementy ekonomi
wykład 7- 25.11.2009
Wykład 8 - 11.04.2011 + właściwości i podział materiałów, Budownictwo, BuDOC
6 Bankowość wykład 25.11.2008, STUDIA, Bankowość
FINANSE PRZEDSIĘBIORSTW WYKŁAD 4 (25 11 2012)
Wykład 8 - 11.04.2011, Budownictwo, BuDOC
petrologia7 25.11, Studia (Geologia,GZMIW UAM), II rok, Petrologia, Wykłady, Wykłady
więcej podobnych podstron